直流偏压对HMDSO制备C:SiOX膜层性能的影响
HMDSO制得C:SiOX膜层包括出众的耐金属金属腐蚀耐热性,上篇讲到HMDSO/O2比例表对膜层有效成分,耐金属金属腐蚀耐热性与氏硬度影向。在某个表层的镀膜过程中 中,偏压也是影向HMDSO制得的C:SiOX膜层耐热性的问题一个。
A.J. Choudhury等人[1]使用RF-PACVD方式,使用HMDSO制备了C:SiOX膜层,并研究了偏压对膜层性能的影响。表1是各组实验参数,负偏压由40V至160V变化,离子能量也随之逐步增强;但是膜厚与沉积速率先增加后下降,在负偏压为100V时最高。

表1 各组工作产品参数经途XPS分析一下,取得了每组膜层的SiO4,SiO3CH3,SiO2(CH3)2基团的比重。从图2中也可以可以看出,伴随负偏压由40V上升160V,膜层中高分子硅(SiO4)份量先添加后增多,在100V时,份量最多;而可挥发硅(SiO3CH3,SiO2(CH3)2)份量却刚好相反的成语,先降低了大约后添加,并在100V时份量至少。

图2 各个偏压下充分物硅与充分硅含量变迁 (a)-40V, (b)-70V, (c)-100v, (d)-130V, (e)-160V
还,论述相关人员也试验了各组样机的强度并且 裂痕试验(如同3)。临界点状态承载力,納米强度与露珠角都有伴随负偏压的提升先提升后骤降,在100V时满足极值。融入XPS后果介绍,这种基本特征或许是会因为在负偏压40V变高到100V时,膜层中硅酸硅(SiO4)提升,Si-0-Si障碍避免,会造成膜层硅酸基本特征提升,强度,临界点状态承载力并且 露珠角变高;在负偏压由100V变高到160V时,阴离子能力不断减少,堆积时轰击基片能力也不断减少,溅射边际效应提升,会造成膜层中i-0-Si障碍提升,可挥发硅(SiO3CH3,SiO2(CH3)2)的含量减少,有效的效能骤降。
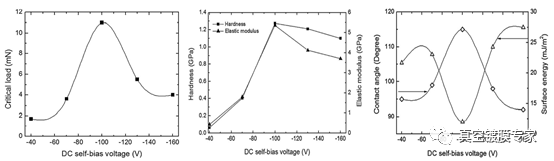
总结
使用的RF-PACVD行为,以HMDSO配制了C:SiOX膜层时,膜层的nm氏硬度,临界点点状态反力及水珠角等安全使用性能跟着整流偏压的添加会先添加之后在减小,这是鉴于跟着整流偏压添加,阴阳离子卡路里会添加,在另一临界点点状态卡路里前,对膜层有增益值功用;不超该临界点点状态值,则会对早先膜层导致轰击,弄坏早先膜层生涨构成,带来安全使用性能的降低。


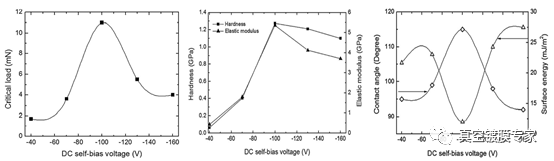
 18922924269
18922924269
